今回のブログは、基板の表面処理について紹介します。
プリント基板は、紙やガラス基材に樹脂を浸透させた絶縁版に銅箔を
張りつけた銅張積層板(Copper Clad Laminate)を加工したものです。
エッチングや積層などを施してプリント基板を製造しています。
名前の通り、プリント基板の導電部分(パターン)は銅です。
空気に触れることで徐々に酸化し錆びてしまいます。
部品実装などで半田付けする部分を除き、レジストを
塗布することで表面を保護し、酸化を防止しています。
(酸化だけでなく、絶縁性等も含めた基板保護になります)
半田付け部分はどうするのか・・・と、いうのが、
今回紹介する基板の表面処理になります。
基板の表面処理は大きく分けて3種類あり、
①プリフラックス
②半田レベラー
③金メッキ
となります。
①プリフラックス
水溶性フラックスを塗布した表面処理です。
フラックス、プリフラックス、OPS(Organic Solder preservative)など、
色々な呼ばれ方をします。弊社では「フラックス」と呼んでいます。
フラックスは無色透明で、何もコーティングされていないように見えます。
プリント基板の製造では最も一般的に使用される表面処理方法です。
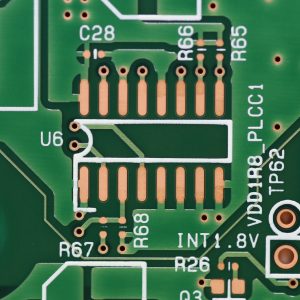
・長所
コストが最も安価
半田濡れ性が良い
平坦度があり、チップ部品の実装に適している
・短所
保管期限が短い(通常、2~3カ月)
導電性が無い
等があります。
●保管期限について
適切な保管を行った場合の保管期限になります。
通常は直射日光を避け、温度25度以下、湿度50%RH以下での保管が目安のようです。
なお、IPCでは湿度10%RH以下で保管するように定められています。
(IPCについては後日記事にする予定です)
なお、このフラックス仕上げは部品実装・半田付け前に
塗布されるフラックスとは全く異なる処理です。
区別するために、基板製造時の表面処理を「プリフラックス」、
部品実装前に行う処理を「ポストフラックス」と呼んでいます。
②半田レベラー
溶融した半田を浸潤塗布し、余分な半田を熱風で吹き飛ばして仕上げる表面処理です。
パッドやランドに半田が付いた外観になります。
長期保管が必要な場合に選択されます。

・長所
保管期限が長い(6カ月)
フラックスの次に安価
半田濡れ性が高く、特にリード部品の半田上がりが良い
・短所
平坦度が低い
半田ブリッジが発生しやすい
スルーホール/VIAの内壁に半田が付く為、穴径が(他の表面処理に比べ)小さくなる
等があります。
平坦度が低いというのが、どういった状態かというと・・・

このように、半田は熱風で吹き飛ばした後に冷えて固まりますが、
半田の多い部分と少ない部分が発生し、凹凸が発生します。
余分な半田が半田ブリッジの発生につながることもあります。
また、半田レベラーには、共晶(有鉛)半田と鉛フリー(無鉛)半田がありますが、
現在は鉛フリーが殆どです。弊社でも指定が無ければ鉛フリーとなります。
(特殊用途でなければ共晶(有鉛)半田レベラーは選択されません)
続いて金メッキなのですが、長くなってしまいましたので・・・
次回もお楽しみに!
@kitaoka